|
МАТЕРИАЛ
|

|
Это заготовка внутреннего слоя многослойной печатной платы. Диэлектрический материал, например текстолит, ламинированный медной фольгой. Толщина меди обычно составляет от 0,018 мм до 0,07 мм.
|
|
ЛАМИНИРОВАНИЕ ФОТОРЕЗИСТОМ
|

|
Следующий этап - нанесение пластичного фоточувствительного материала на заготовку. Заготовка очищается и приготавливается к нанесению фоторезиста. Этот этап проходит в чистой комнате с желтым освещением. Резист светочувствителен (обычно к ультрафиолету) и при долгом не использовании разрушается.
|
|
РАЗМЕЩЕНИЕ ФОТОШАБЛОНА
|

|
На заготовке размещается фотошаблон. На рисунке изображена только его малая часть. Круг, часть которого изображена, в последствии будет соединением с внутренним слоем. Изображение на фотошаблоне негативное по отношению к будущей схеме. Под темными участками фотошаблона медь не будет удалена.
|
|
ЭКСПОНИРОВАНИЕ ФОТОРЕЗИСТА
|

|
Участки поверхности незащищенные фотошаблоном засвечиваются. Фотошаблон снимается. После этого засвеченные участки могут быть удалены химически.
|
|
ОБРАБОТКА РЕЗИСТА
|

|
Засвеченные участки резиста удаляются, оставляя резист только в тех областях, где будут проходить дорожки платы. Назначение резиста - защитить медь под ним от воздействия травителя на следующем этапе.
|
|
ТРАВЛЕНИЕ
|

|
Заготовка травится для удаления ненужной меди. Резист, оставшийся на поверхности предохраняет медь под ним от травления. Вся незащищенная медь удаляется, оставляя диэлектрическую подложку. После травления дорожки схемы созданы и внутренний слой имеет требуемый рисунок.
|
|
УДАЛЕНИЕ РЕЗИСТА
|

|
Резист удаляется, открывая невытравленную медь. Теперь заготовка представляет собой полностью готовый внутренний слой. В нашем примере она будет вторым и третьим слоями будущей платы. На следующем этапе на нее наносятся верхний (первый) и нижний (четвертый) слои платы.
|
|
ЛАМИНИРОВАНИЕ ПЕЧАТНОЙ ПЛАТЫ
|

|
На этом этапе внутренний слой является центром многослойной платы. Слои одностороннего текстолита добавляются сверху и снизу внутреннего слоя. Затем соединенные слои ламинируются под прессом при высокой температуре и давлении. Скрепление происходит путем адгезии текстолита к внутреннему слою.
|
|
СВЕРЛЕНИЕ
|

|
Плата сверлится там где требуется металлизация отверстий. В нашем примере отверстие просверлено сквозь площадку на втором слое. В то же время пересечения с рисунком третьего слоя нет. Взаиморасположение просверленных отверстий с рисунком слоев существенно.
|
|
ОСАЖДЕНИЕ МЕДИ
|

|
Этот этап служит для покрытия отверстия тонким слоем металла. Проблемам в том, что поверхность отверстия непроводящая. Для металлизации плата помещается в ванну, где плата полностью покрывается тонким слоем меди. Сущность процесса химическая и в результате покрываются как диэлектрические, так и металлические поверхности.
|
|
НАНЕСЕНИЕ РЕЗИСТА
|

|
Далее плата покрывается резистом, резист засвечивается через фотошаблон, засвеченные участки удаляются. Эти этапы аналогичны описанным ранее с одним отличием: резист удаляется с участков, где будет наносится медь. Следовательно, изображение на фотошаблоне должно быть позитивным.
|
|
ЭЛЕКТРОЛИТИЧЕСКОЕ НАНЕСЕНИЕ МЕДИ
|
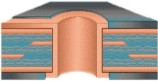
|
Медь наносится на поверхность отверстия до толщины 0,25мм. Медь, осажденная ранее на поверхность отверстия достаточно толстая, чтобы проводить ток, необходимый для электоролитического осаждения меди. Это необходимо для надежного электрического соединения сторон и внутренних слоев платы.
|
|
ОЛОВЯННО-СВИНЦОВОЕ ПОКРЫТИЕ
|
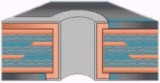
|
Оловянно-свинцовое электролитическое покрытие выполняет две важные функции. Во-первых, оловянно-свинцовая смесь выступает резистом для последующего травления. Во-вторых, она защищает медь от окисления. Если плата производится не по процессу SMOBC, тогда эта смесь может быть расплавлена в печи для лужения дорожек.
|
|
УДАЛЕНИЕ РЕЗИСТА
|

|
Резист удаляется, оставляя оловянно-свинцовую смесь (припой) и нанесенную медь. Медь, покрытая припоем, выдержит процесс травления и образует собой рисунок платы.
|
|
ТРАВЛЕНИЕ МЕДИ
|

|
На этом этапе припой используется как резист для травления. Незащищенная медь удаляется, оставляя на плате рисунок будущей схемы.
|
|
УДАЛЕНИЕ ПРИПОЯ
|

|
Припой удаляется с поверхности меди и плата очищается. Это начало процесса, называемого SMOBC (solder mask over bare copper - маска поверх необработанной меди). В других процессах, оловянно-свинцовая смесь расплавляется для дальнейшего использования (лужение).
|
|
НАНЕСЕНИЕ МАСКИ
|
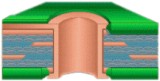
|
Для защиты поверхности платы, где в дальнейшем не потребуется пайка, наносится маска. Существует несколько типов масок и методов ее нанесения. Фоточувствительная маска наносится тем же способом, что и фоторезист и обеспечивает высокую точность процесса. Шелкографический способ нанесения не обладает такой точностью, но материал маски более пластичен.
|
|
HAL (Hot Air Leveling - выравнивание горячим воздухом)
|
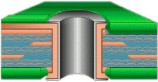
|
Припой наплавляется на незащищенную маской медь, сохраняя ее от окисления. В отличие от других процессов, под маской припоя не остается. Плата SMOBC готова для заключительных этапов: нанесения надписей (шелкография), резки, тестирования и упаковки.
|
